精确测量光学涂层厚度
来源:深圳市凯茉锐电子科技有限公司2025-08-07
许多种计量工具已被用来测量薄膜厚度,这些措施包括一些常规的方法,如分光广度法、椭偏法和物理台阶测量。其它方法也被用来勘测薄膜的厚度,如波长干涉法、棱镜耦合器法和激光束的热波检测法。衡量表面粗糙度的计量工具也有多种类型的,如触针式轮廓仪和连贯扫描干涉仪Coherence Scanning Interferometry (CSI)。连贯扫描干涉法(CSI)正在成为流行的技术,由于其高的横向分辨率和测量速度。然而,传统的干涉仪的局限性之一就是可以被测量涂层的厚度;通常,这需要大于1~1.5微米,才能获得准确的数据。现在用连贯相关干涉Coherence Correlation Interferometry(CCI)加Helical Complex Field(HCF),能够让可测量的厚度达到50纳米或更小。
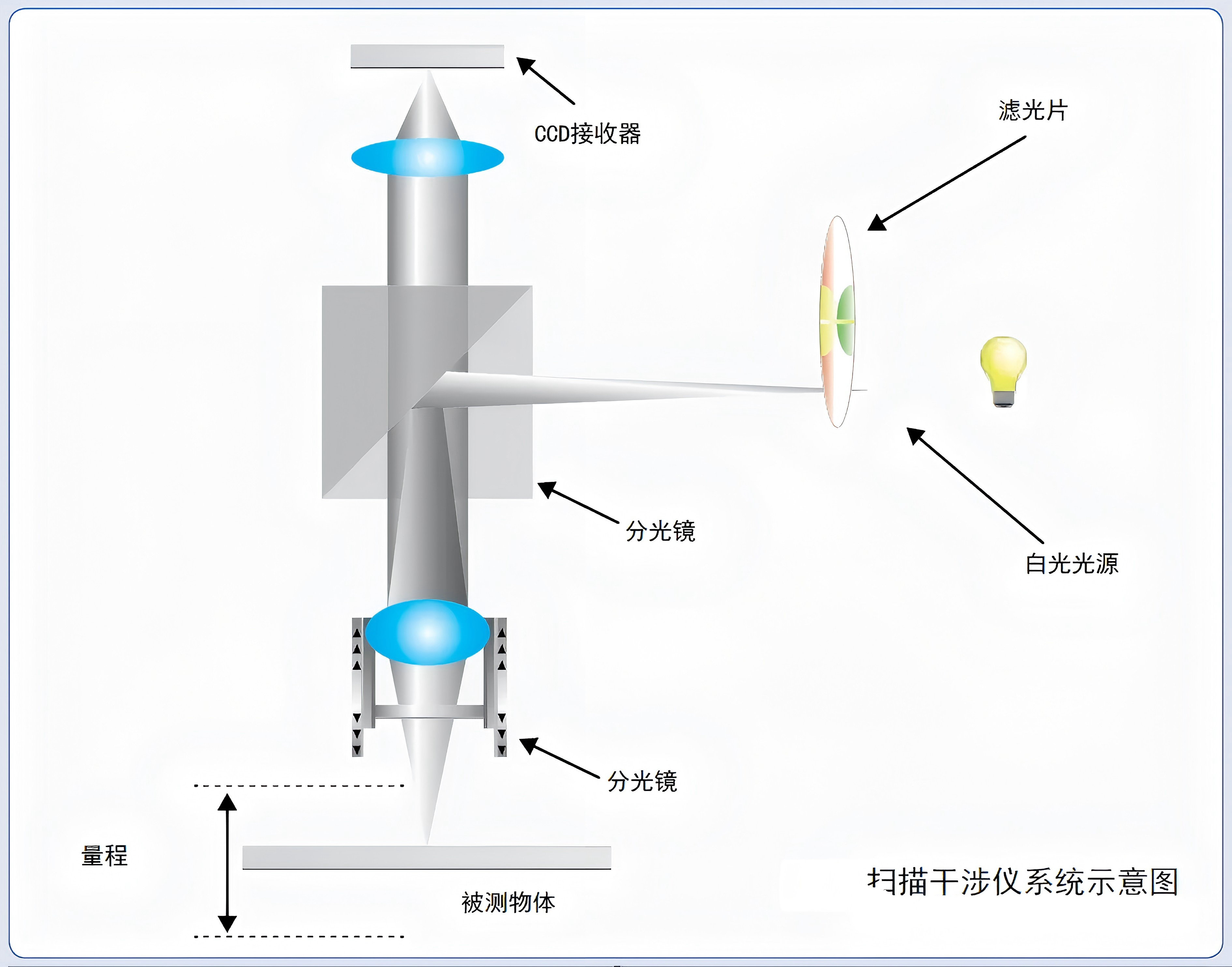
扫描干涉仪系统的示意图如图1所示。来自光源的光被上分束器引导向物镜,然后光被下分束器分为两个单独的光束。一个光束指向样品,另一个光束则指向内部参考镜。这两个光束重新组合并被发送到探测器。当干涉物镜在z方向上扫描时,当两个光束的路径长度相同时,就会发生干涉。探测器测量强度,在测量样品时拍摄一系列快照。这创建了从表面反射的光的强度图,然后用于创建被测量表面的3D图像。使用不同的技术来控制干涉仪的运动以及计算表面参数。扫描白光测量的准确性和可重复性取决于扫描机构的控制和根据干涉数据计算表面性质。CCI相干相关干涉术在许多应用中的测量变得越来越重要,提供:•全自动无损测量•表面的精确和定量表征•无论使用何种扫描范围,分辨率均为亚埃•快速方便的样品装载和设置•测量各种材料的能力•可重复地测量•一次测量中的粗糙度和台阶高度分析•薄膜厚度和界面表面测量能力薄膜厚度的测量干涉法的一个重要延伸是测量薄膜厚度的能力。当干涉信号在薄膜表面出现时,一种特殊的算法可以从干涉图中提取薄膜厚度。在某些情况下,表面的信息也可以得到。CCI的技术提供了两种不同的薄膜厚度测量的解决方案: • 厚膜(>1.5微米) • 薄膜厚度分析(小到50纳米或更小)传统厚膜测量当薄膜的厚度大于1.5微米时(取决于折射率),Stroboscopic White Light Interferometry (SWLI)可以从两个表面中生成两组条纹。

薄膜的厚度可以由两个极大值的位置和应用相应材料折射率来得到。此外,两个界 面(空气/薄膜和薄膜/基体)表面的信息可从分别的干涉条纹得到。
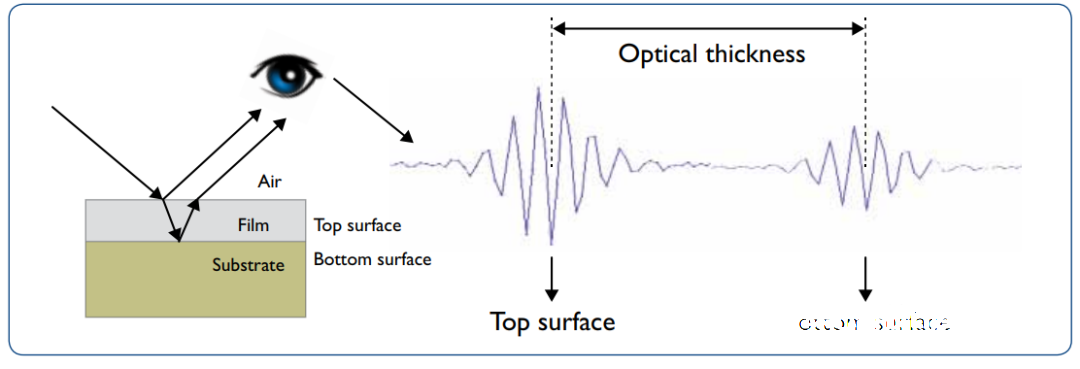
厚膜的限制随着薄膜厚度的减小,这两组条纹会更加接近和重叠,直到他们最后成为一堆的干涉条纹。下图是单个像素点测量270纳米的薄膜。

对于厚度小于1.5微米(取决于折射率)的薄膜, 由于边缘的失真,使用厚膜的技术就不能再提取薄膜的厚度了。下图是不同样品的单像素条纹。

相关资讯
- 2026-05-16
- 2026-05-15
- 2026-05-14
- 2026-05-13
- 2026-05-12
- 2026-05-11






 13798538021
13798538021